11月18日消息,据媒体报道,随着全球ai芯片与高性能计算(hpc)需求持续升温,台积电的cowos(chip on wafer on substrate)先进封装技术成为关键支撑,其产能需求随之迅猛增长。
尽管台积电不断加大投资扩增CoWoS产线,但供需失衡问题依然严峻,产能缺口已成为限制AI与高性能计算芯片出货的主要瓶颈,促使部分客户转向评估包括英特尔在内的替代封装方案。
业内分析指出,当前台积电的CoWoS产能已被英伟达、AMD以及各大云服务商高度锁定,新进客户难以获得充足的排产空间。这一局面推动多家芯片巨头重新审视其他先进封装路径。在该领域,英特尔的技术积累与台积电处于同一竞争梯队。
目前,英特尔主推的先进封装方案主要包括用于2.5D集成的EMIB(Embedded Multi-Die Interconnect Bridge),以及支持3D堆叠的Foveros技术。
作为市场主流的台积电CoWoS则属于2.5D大型硅中介层封装方案,具备支持多颗HBM高带宽内存堆叠的能力,是当前AI GPU最广泛采用的核心封装技术。相较于英特尔的EMIB和Foveros,CoWoS在工艺成熟度、量产规模及生态合作方面仍具优势,拥有更广泛的HPC与GPU客户基础。
 Anyword
Anyword
AI文案写作助手和文本生成器,具有可预测结果的文案 AI
 153 查看详情
153 查看详情 
然而,随着AI训练、数据中心升级以及定制化芯片(如ASIC)需求激增,头部半导体企业正加速调整供应链策略。近期苹果与高通在招聘中明确青睐具备英特尔先进封装经验的人才,释放出明显的供应链多元化信号。
展望未来,先进封装市场或将逐步由“台积电CoWoS单极主导”演变为“台积电与英特尔双轨并行”的供应格局,从而提升整个产业链的弹性与抗风险能力。
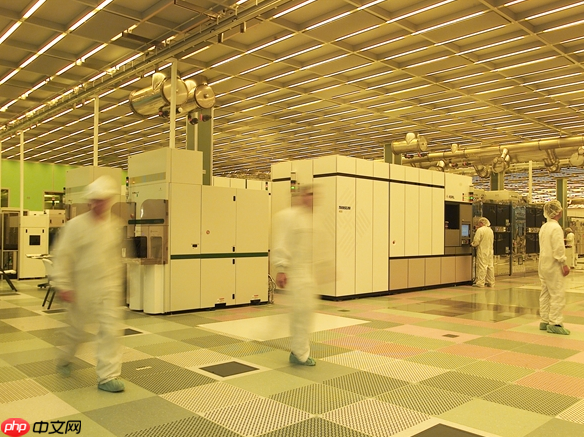
以上就是台积电封装产能供不应求 苹果高通转向英特尔寻求破局的详细内容,更多请关注创想鸟其它相关文章!
版权声明:本文内容由互联网用户自发贡献,该文观点仅代表作者本人。本站仅提供信息存储空间服务,不拥有所有权,不承担相关法律责任。
如发现本站有涉嫌抄袭侵权/违法违规的内容, 请发送邮件至 chuangxiangniao@163.com 举报,一经查实,本站将立刻删除。
发布者:程序猿,转转请注明出处:https://www.chuangxiangniao.com/p/865452.html

 微信扫一扫
微信扫一扫  支付宝扫一扫
支付宝扫一扫 






















